微細構造観察(TEM)

収差補正分析電子顕微鏡による高感度元素分析
電子デバイスやエネルギーデバイスなどの機能デバイスに加え、ナノテク材料分野では、対象となる観察・分析の領域も極めて微小になっています。最先端の評価機器と長年蓄積してきたノウハウを駆使し、年々高度化する分析ニーズにお応えします。
背景
先端材料開発では材料の構造・組成の制御が原子レベルにまで達しており、高分解能分析電子顕微鏡は不可欠な分析ツールとなっています。高感度元素分析システムを搭載した収差補正分析電子顕微鏡により、高い空間分解能での元素分析だけでなく高感度を活かした高速・低ダメージでの元素分析が可能です。

特長
-
1.高感度・高精度組成分析
高感度元素分析システムにより、高速・低ダメージでの元素分析が可能です。 -
2.高分解能STEM像観察
冷陰極電界放出電子銃(Cold-FEG)に球面収差補正装置を組み合わせることで良質な高分解能STEM像観察が可能です。 -
3.評価目的に応じた多彩な特殊観察
環境制御、冷却、3次元観察等の専用ホルダーを準備し、多彩な特殊観察/分析が可能です。
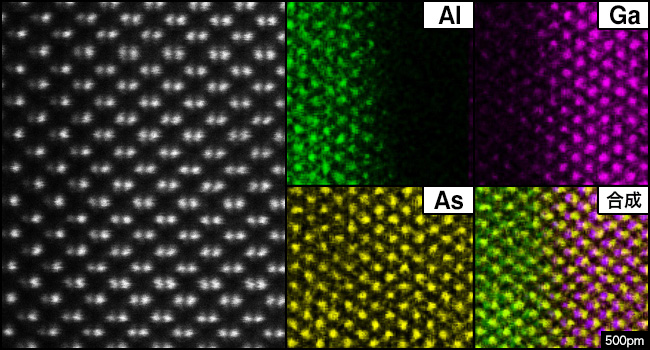
解説
| 用語 | 概要 |
|---|---|
| 透過電子顕微鏡 (TEM)像 transmission electron microscope(TEM)image |
試料を透過してくる電子(透過電子)で結像する像で弾性散乱電子で作られる。観察法には明視野法と暗視野法がある。 |
| 走査透過電子顕微鏡 (STEM)像 scanning transmission electron microscope(STEM)image |
微小電子プローブで薄片試料を走査し、試料から出てくる透過波(または回折波)の強度を円盤状の検出器で受け、その強度をプローブ走査と同期させてモニタ上に表示して得る像。分解能はプローブ径によって決まり、観察法には明視野法と暗視野法がある。 |
| 暗視野像 dark-field image |
直接透過する電子線をさえぎり、散乱した電子線のみを利用して像を観察している。暗視野像では、結晶粒界や双晶面などの各種の境界線が明瞭になる特徴がある。 |
| 明視野像 bright-field image |
試料で散乱・回折を受けずに透過してきた電子線を結像した像で回折を起こしている場所は暗く、回折を起していない部分は明るく見える。暗視野像とともに、試料の膜厚測定や格子欠陥の解析に利用される。 |
| 球面収差 spherical aberration |
電子線がレンズの周辺部を通ると、理想的な像面で光軸上に来ず、光軸からずれた位置(電子顕微鏡の場合は少し手前(レンズ側))に来るために、円状のぼけた像を作る収差。対物レンズの収差のうちで最も重要な収差。 |
| 球面収差補正装置 (Csコレクター)Cs corrector |
負の球面収差係数を作り出し、磁界軸対称レンズである対物レンズ、コンデンサーレンズの正の球面収差係数を打ち消す装置。対物レンズの球面収差の補正による高いTEM像分解能、コンデンサーレンズの球面収差の補正による、高分解能のHAADF像、一原子列からの元素分析が可能になる。 |
| 電子回折 electron diffraction |
試料に電子線を照射し、得られる回折図形から結晶構造の情報を得る手法。試料が結晶の場合は、原子配列の規則性、周期性、対称性、結晶格子の完全性からの乱れなど結晶構造についての情報が得られる。試料が非晶質の場合は第一、第二、...近接原子の距離、個数などがわかる。電子線はX線よりビームを細くできるので、局所領域から回折図形を取得可能。 |
| エネルギー分散型X線分光 energy-dispersive X-ray spectroscopy(EDS) |
電子線を照射し、試料から発生したX線のエネルギーを分解してそのスペクトルから試料に含まれる元素を分析する。波長分散型と比べ軽い元素(B:ボロン以下)は分析できないが、検出効率は高い。また照射電流量は波長分散型より少なくてすむので試料へのダメージは少ない。 |
| 弾性散乱電子 elastically scattered electron |
入射電子が原子と衝突し進行方向を変える(散乱)とき、そのエネルギーを失わずに散乱される電子。試料が薄い場合は、TEM像や回折図形の強度は弾性散乱電子で説明ができる。試料が厚くなると(10nm)、非弾性散乱電子の影響を考慮しなければならない。 |
| 非弾性散乱電子 inelastically scattered electron |
入射電子が結晶中の電子や結晶格子と相互作用をしてそのエネルギーを一部失って散乱される電子。非弾性散乱が起こる確率は弾性散乱に比べ一桁以上小さいが、試料が厚くなると(10nm以上)、非弾性散乱電子の寄与が弾性散乱に重なり、TEM像や電子回折図形が不明瞭になる。非弾性散乱を取り除くには、エネルギーフィルタを搭載した透過電子顕微鏡が使われる。 |
| 電子エネルギー損失分光 electron energy-loss spectroscopy(EELS) |
入射電子と試料の相互作用で生じる非弾性錯乱電子のエネルギーを分光して、微小領域から元素の定性定量分析や電子状態を解析する手法。 |
| 高角度散乱暗視野(走査透過電子顕微鏡)法 high-angle annular dark-field scanning transmission electron microscopy(HAADF-STEM) |
走査透過電子顕微鏡法(STEM)で、格子振動による熱散漫散乱によって高角度に非弾性散乱された電子を円環状の検出器で受け、その強度を像として表示する手法。周期性のない物質にも使え、像強度は原子番号の二乗に比例し、重い原子が選択的に観察できる。分解能は入射ビームサイズで決まり最高性能の装置は0.1nm以下で、EELSとの併用で、原子レベルの元素分析が可能。 |
| トモグラフィー tomography |
試料を連続的に傾斜させて撮影した多数の投影像をコンピュータで画像処理し、3次元的内部構造を再構成する手法。医療分野などで用いられているX線CT、MRIなどによる断層撮影の原理を、TEM像に応用した手法。 |
| 格子像 lattice image |
薄い結晶性の試料からの透過波と回折波を干渉させて得られる結晶の格子に対応する像。格子像の強度変化は入射電子線の方向に投影した試料の静電ポテンシャルの変化に正しく対応はしないが、結晶の周期構造を知ることが可能。 |
| 結晶方位 crystal orientation |
結晶の方向を、結晶の面指数で表したもの。透過電子顕微鏡による観察の際には、結晶を特定の方位(特に低次の指数で表される方位)を入射電子線の方向に合わせることが行われる。 |
技術事例
お問い合わせ・ご相談
