局所空間中のケミカル汚染分析

製造プロセスにおける局所空間のケミカル汚染(分子状汚染物質)状況の把握と清浄度管理を支援いたします。
有機エレクトロニクス分野において重要な多層薄膜構造の評価を、最適な分析手法でサポートします。結晶性や配向性、膜厚、表面粗さ、界面状態など、デバイス性能に直結する特性を多角的に解析。先端技術を駆使し、試料の状態や目的に応じた最適な評価を実現します。
特長
-
1.装置内、FOUP、ウェーハケース、マスクケースなど多様な局所空間の評価に対応できます。
-
2.基板曝露法とガス捕集法を併用して基板表面に付着しやすい成分を特定することができます。
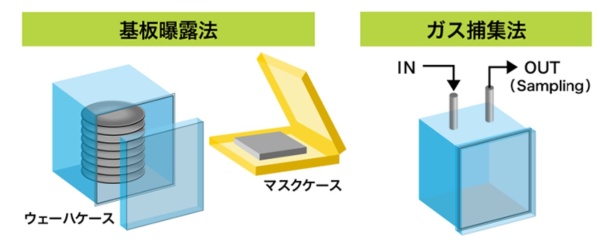
分析項目
基板曝露法
| 項目 | 測定項目 | サンプリング方法 | 前処理 | 測定方法 |
|---|---|---|---|---|
| 有機成分 | 揮発性有機物 | 基板曝露
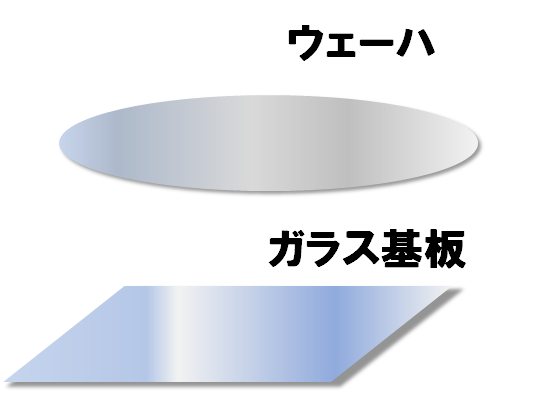
|
|
WTD-GC/MS GC/MS TOF-SIMS |
| イオン成分 | 酸、アルカリ アミン成分 |
|
IC CE,CE/MS, CE/TOFMS TOF-SIMS |
|
| 金属成分 | 金属成分 |
|
ICP-MS TOF-SIMS |
ガス捕集法
| 項目 | 測定項目 | サンプリング方法 | 測定方法 |
|---|---|---|---|
| 有機成分 | 揮発性有機物 |
|
GC/MS |
| イオン成分 | 酸、アルカリ アミン成分 |
|
IC CE,CE/MS, CE/TOFMS |
| 金属成分 | 金属成分 |
|
ICP-MS |
- WTD: ウェーハ加熱脱離装置
- GC/MS: ガスクロマトグラフ - 質量分析装置
- TOF-SIMS: 飛行時間型二次イオン質量分析装置
- IC: イオンクロマトグラフ分析装置
- CE: キャピラリー電気泳動装置
- TOFMS: 飛行時間型質量分析装置
- ICP/MS: プラズマ質量分析装置
事例:基板曝露法とガス捕集法による基板への影響評価
基板曝露法とガス捕集法を併用することにより基板表面へ吸着しやすい成分の特定ができます。
ガス捕集法の測定結果から空間には低沸点成分が多く存在し、高沸点成分がほとんど確認されませんでした。しかし、基板曝露法では高沸点成分が多く基板に付着しており空間濃度の高い成分が必ずしも基板への付着量が多い結果にはならないことがわかります。

関連ページ
技術事例
お問い合わせ・ご相談
